- HOME
- VENUE
- RSVP
- REGISTRY
- CONTACT
- Download god of war 3 ps2 iso
- Akvis smartmask 8-0 full
- Windows 10 1809 iso upgrade all versions
- Save titanfall
- Silent install builder inf
- The souljazz orchestra mista president lyrics
- Ntfs permissions
- Original mission impossible theme sheet music
- Evga gigabyte b360m ds3h installation video
- Vce reader free download full version windows
- Minitab 16 free trial download
- The office season 8
- Japanese karaoke box
- Hickvision ivms 4200 client
- Advanced systemcare ultimate 7
- Nba 2k13 apk free download
- Reflex arena fullscreen not working
- Generals zero hour no cd patch
- Datacon 2200 evo plus issues
- 9th grade shsat practice test 2017
- Gigabyte b360m ds3h no internet
- Anime character database gemini
- Buy oxygen forensics
- Blendtec icb3 refurbished
- Watch exes and ohs season 1

The system offers outstanding flexibility with a modular design and can be easily reconfigured for different applications. Bond process changes are easily achieved.įINEPLACER® lambda Flexible Sub-micron Die BonderThe FINEPLACER® lambda is a flexible sub-micron bonder used for precise placement, die attach and advanced packaging. Active leveling is made possible through a motorized pitch & roll system combined with autocollimation or laser leveling. The FC150 accommodates a wide variety of processes and materials, including extremely fragile materials such as GaAs and HgCdTe. Available as a fully automated system to level, align and bond components ranging in size from 0.2 to 100 mm, the FC150 supports a complete range of bonding applications, including Reflow, Thermo-compression, Thermosonic, Adhesives and Fusion bonding.
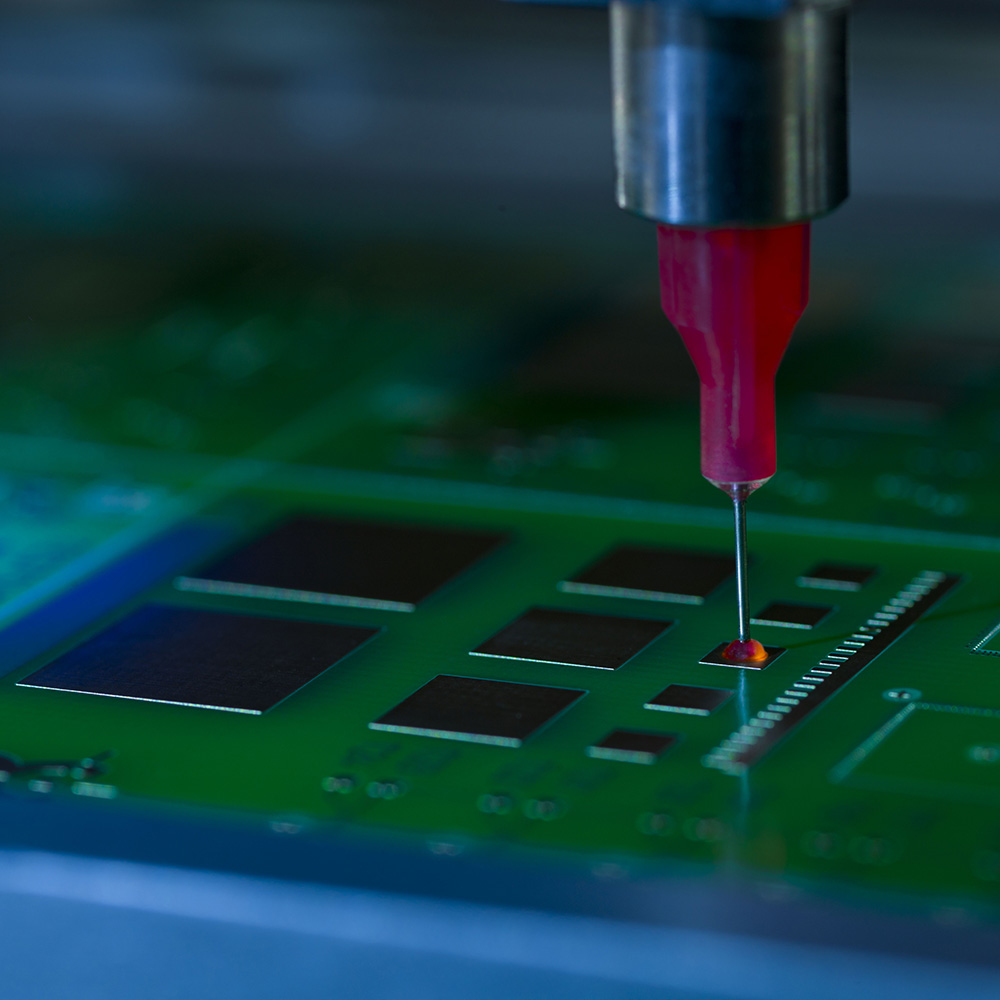
Designed to maximize accuracy and versatility, the FC150 answers almost every need in high-end bonding applications. The high degree of flexibility offered on the FC150 makes it the machine of choice for advanced research with the ability to move directly into pilot production.
#Datacon 2200 evo plus issues manual#
With configurations ranging from manual to full automation, the FC150 provides development and production capabilities on a single upgradeable cost-effective platform. SET FC 150 FC150: The Most Flexible High Accuracy Die Bonder with ± 0.5 µm placement accuracy and ± 1 µm post-bond accuracy, the SET FC150 Die/Flip Chip Bonder offers the latest evolutions in bonding techniques. * depending on configuration and application

Matching the requirements of IDMs and subcons (90% market share).Field-proven, reliable machine concept and production process.No restriction on substrate type (lead frames, strips, panels, wafers).Capability to handle any flip chip size.Operator-independent quality by fully automatic machine calibration.Exceptional accuracy of ± 10µm 3 Sigma at highest speed.Beside the factory-proven QUANTUM values it provides superior speed and accuracy while drastically improving your cost-of-ownership Reliable and accurate flip chip processĭATACON 8800 FC QUANTUM SIGMA The Datacon 8800 FC QUANTUM sigma flip chip bonder represents the next generation of the high-volume, high-accuracy 8800 platform.Operator independent results ensured by auto calibration.Full recipe transfer from machine to machine.Load recipe from host and run on any machine.Innovative parallel activity machine design with Phi-Y movement pick-and-place.Low vibrations – no time wasted for motion settling.Simultaneous movement of chip and camera – no time wasted for image taking.
#Datacon 2200 evo plus issues free#
Equipped with integrated dispenser, 12” wafer handling, automatic tool changer, and application specific tooling, the 2200 evo is prepared for present and future processes and products.ĮSEC 2100 FC PLUS Esec as a renowned leader in providing die bonders for trouble free high quality mass production has integrated flip chip capability into its 2100 family of die bonders: Esec’s response to driving down the cost of flip chip technology. Test Handlers, Test interfaces, ManipulatorsĭATACON 2200 evo The 2200 evo high-accuracy multi-chip die bonder provides the ultimate flexibility for die attach as well as for flip chip applications.IC Characterization and Functional Evaluation Test System.DC, RF, Resistivity probes and probe cards.

